董海青 张照锋


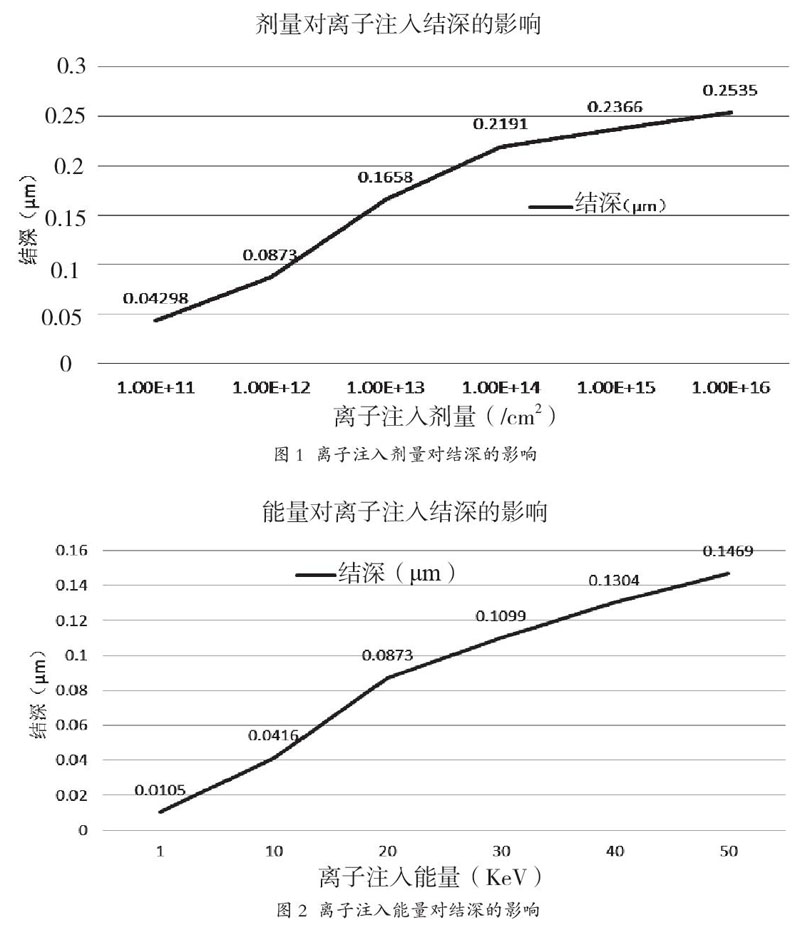
摘? 要:该文主要是通过TCAD工具分析工艺对集成电路工艺结果的影响,通过TCAD工具模拟集成电路离子注入工艺的过程,然后分别改变离子注入的工艺参数,分析离子注入工艺参数对结深结果的影响,进而在器件设计过程中合理地进行工艺优化。
关键词:工艺;器件;仿真
中图分类号:TN305? ? ? ? ? ? 文献标志码:A
0 引言
TCAD软件按照功能可分为3个模块,最底层是工艺仿真模块,用来确定标准工艺下材料水平的器件结构,标准工艺包括氧化、扩散、离子注入、干湿法刻蚀、光刻,一些比较新的TCAD也包括CMP以及用于制造SOI衬底的Smart cut工艺。仿真主要考虑的因素包括杂质扩散、注入杂质和晶格作用声学模型、各种thermal budget和机械力下的应力、材料各向异性等。然后是器件仿真,在前面工艺仿真得到的器件结构的基础上计算电学行为。最顶层是提参模块,其是从电学仿真结果中提取符合BSIM标准的器件参数,用于SPICE仿真,我们平时使用写网表时,引用的lib文件就是该类参数的list[1]。
通过相关命令分析元器件的工作过程,进而判断其相应的参数是否符合要求,反过来对工艺过程进行优化。
1 工艺过程模拟
工艺是集成电路制造过程中的重要环节,特别是特征尺寸越来越小的今天,7 nm工艺已经开始量产,不断缩小的特征尺寸对工艺提出了更加严苛的要求。因此,在进行真正的工艺流片之前,一定要先进行工艺模拟,即通过计算机EDA工艺分析并计算工艺过程,得出相应的理论数据,然后再与实际的工艺过程结果数据进行比对,这样可以最大限度地减小因工艺误差带来的经济损失[2]。
1.1 硅片初始化
首先创建一个0.6 um×0.8 um模拟区域,将该区域划分成一个非均匀网格。对应语句如下:
line x loc=0.00 spac=0.1
line x loc=0.2? ?spac=0.01
line x loc=0.6? ?spac=0.01
line y loc=0.00 spac=0.008
line y loc=0.2? ?spac=0.01
line y loc=0.5? ?spac=0.05
line y loc=0.8? ?spac=0.15
然后用init语句初始化硅片参数,P型硅衬底,衬底浓度为1×1016/cm3,晶向为100。对应的语句如下:
init silicon c.boron=1.0e16 orientation=100 two.d
最后用Structure命令保存结构文件。对应的语句如下:
structure outfile=nmos.str
1.2 离子注入工艺
离子注入工艺是将加速到一定高能量的离子束注入固体材料表面层内,以此来改变表面层物理和化学性质的工艺。在半导体中注入相应的杂质原子(如在硅中注入硼、磷或砷等),可改变其表面电导率或形成PN结[3]。
离子注入对应的命令是implant,其中主要包括3个参数。1)离子注入源的离子类型,boron代表硼离子。2)离子注入的剂量,即浓度。3)离子注入的能量,即施加在离子上的动能[4]。对应的命令语句如下:
implant boron dose=9e11 energy=10 crystal
其中boron代表离子注入源是硼离子,dose=9e11代表离子注入的剂量为9×1011/cm2,energy=10代表离子注入的能量为10 KeV。
使用的Extract语句提取离子注入形成的结深,具体命令语句如下:
extract name="nxj" xj material="Silicon" mat.occno=1 x.val=0.2 junc.occno=1
提取名称为“nxj”,材料为“Silicon”,在mat.occno=1? x.val=0.3处提取。
2 离子注入工艺参数模拟
离子注入工艺的参数主要包括离子注入源、离子注入剂量和离子注入能量。
2.1 离子注入源剂量的模拟
离子注入源的剂量,即离子注入时单位面积内离子源的数量。
设定离子注入的离子源为boron,离子注入的能量为20 KeV,离子注入源的剂量为1×1012/cm2,执行模拟命令:implant boron dose=1e12 energy=20 crystal。
提取离子注入后的结深,执行提取命令:extract name="nxj" xj material="Silicon" mat.occno=1 x.val=0.2 junc.occno=1。
然后改变离子注入源的剂量,分别设定离子注入源剂量为1×1011/cm2、1×1012/cm2、1×1013/cm2、1×1014/cm2、1×1015/cm2、1×1016/cm2,分别提取每次离子注入后的结深数据,最后进行数据汇总分析。得到的离子注入结深见表1。
由表1的数据可以看出,在离子注入能量不变的情况下,随着离子注入剂量的增加,结深增加,但最开始的增加幅度比较大,剂量越大,结深增加的越不明显。
2.2 离子注入能量的模拟
离子注入的能量,即离子注入过程中激发离子时所施加的能量,单位为电子伏特。
设定离子注入的离子源为boron,离子注入的能量为20 KeV,离子注入源的剂量为1×1012,执行模拟命令:implant boron dose=9e12 energy=20 crystal。
然后改变离子注入的能量,分别设定离子注入的能量为1 KeV、10 KeV、20 KeV、30 KeV、40 KeV、50 KeV。分别提取每次离子注入后的结深数据,最后进行数据汇总分析。得到的离子注入结深见表2。
由表2的数据可以看出,在离子注入剂量不变的情况下,随着离子注入能量的增加,结深增加,但最开始的增加幅度比较大,随着能量越大,结深增加的越不明显。
分析对比2组数据,随着离子注入剂量变化对应的结深变化曲线如图1所示。
由图1可以看出,随着离子注入剂量的变化,离子注入结深的变化越来越不明显,即离子注入剂量只能在一定范围内对离子注入结深有较大影响,说明离子注入只能形成比较小的浅结器件。
随着离子注入能量变化对应的结深变化曲线如图2所示。
由图2可以看出,随着离子注入能量的变化,离子注入结深的变化越来越不明显,即离子注入能量只能在一定范围内对离子注入结深有较大影响,说明离子注入只能形成比较小的浅结器件。
3 结论
通过图1和图2可以看出,随着离子注入剂量和能量的变化,离子注入结深的变化越来越不明显,随着注入剂量和能量的增加,结深的增加越来越不明显,即随着离子注入剂量和能量的變化,结深基本不再有很大增加。因此,离子注入工艺一般情况下只能用来形成浅结器件。如果某一类元器件需要比较大的结深,就需要考虑其他工艺,比如扩散或淀积等。
参考文献
[1]张渊.半导体制造工艺(第2版)[M].北京:机械工艺出版社,2015.
[2]王蔚.集成电路制造技术-原理与工艺[M].北京:电子工业出版社,2013.
[3]肖国玲.微电子制造工艺技术[M].西安:西安电子科技大学出版社,2008.
[4]邓善修.集成电路制造工艺员(中级)[M].北京:中国劳动社会保障出版社,2007.
- 隐性课程视野下的幼儿园班级文化建设
- 有效投放游戏材料让区域游戏灵动起来
- 融合与延伸:在统编教材中探索中华传统文化教育的新路径
- 浅析英文报刊阅读教学中提升思维品质的问题设置
- 县校基层“一师一优课、一课一名师”活动存在的问题及对策
- 推进城镇住宅小区配套幼儿园普惠发展的途径
- 推进优质均衡发展 努力办高品质教育
- 智能手机成瘾可预测青少年的物质主义倾向
- 美国加州皇家橡树中学差异化教育印象
- 学前儿童早期执行功能对学业成就的预测作用
- 小学生学习素养调查报告
- 培养小学生计算思维的教学实践
- 超级跷跷板
- 浅议小学综合实践活动中的探究性学习
- 基于儿童立场的立德树人实践
- 多元推进学校体育 全面培养运动能力
- 农村小规模学校推进拓展性课程建设的有效探索
- 农村薄弱高中优质发展的实践路径探究
- 促进教师专业发展提升教师整体素质
- 学校文化管理的思考与实践
- 建设科技拓展课程提升学生核心素养
- 科学思想引领方向务实高效塑造品质
- 创新治理促进区域教育高质量发展
- 网络教研助推乡村教师专业成长
- 美国加州皇家橡树中学的特色教育
- wean sb off sth
- weapon
- weaponed
- weaponing
- weaponries
- weaponry
- weapons
- weapons of mass destruction
- wear
- wriggle out of/worm (your way) out of
- wriggles
- wrigglier
- wriggliest
- wriggling
- wrigglingly
- wring
- wringer
- wringers
- wringing
- wring out
- wrings
- wrinkle
- wrinkleable
- wrinkled
- wrinkledness
- 年头儿
- 年头岁尾
- 年头月尾
- 年奴
- 年好过,月好过,日子难过
- 年安
- 年家
- 年富力强
- 年富力强的时候
- 年寿
- 年寿之长短
- 年寿命运
- 年寿长
- 年寿高的老人
- 年寿,年纪
- 年将二十
- 年尊
- 年小弟
- 年少
- 年少、年轻
- 年少之妻
- 年少之时
- 年少别笑白头人
- 年少功成名就
- 年少幼稚